エレクトロケミカルマイグレーションとは従来のイオンマイグレーションのことを指すもので、国際的な呼称と整合させるためエレクトロケミカルマイグレーションに統一する動きがあります。以下イオンマイグレーションと表記します。
イオンマイグレーション現象とは、プリント基板等で本来良好な絶縁物が、電気的バイアス電圧が印加されている状態で電気化学的な現象でイオンマイグレーションが発生成長し、電極間が短絡する現象です。
プリント基板等でイオンマイグレーションが発生すると部品の損傷〜製品の損傷となり場合によっては多大な損害・損失を生じることもあるため、新素材、および新製品の研究段階における信頼性評価試験の中でも重要な評価項目とされています。
イオンマイグレーション発生メカニズムと発生要因
電界の作用によりイオン化した電子材料に含まれる金属が、電極間を移動して再び金属に還元し析出されます。これを顕微鏡で観察すると樹木の枝状に見えるのでイオンマイグレーション現象の中でもデンドライトと呼ばれます。
デンドライトの成長速度や規模はその金属により異なり、Ag>Pb≧Cu>Sn>Au の順で著しいとされています。これら金属の含有のほか、温度、湿度、電界(電圧)、不純物(イオン・汚染・塵埃等)の存在がイオンマイグレーションの発生要素となります。これらの要素が複合的に作用し、デンドライトは成長し絶縁劣化を引き起こします。
デンドライトの析出は、電極の陽極、陰極のどちらにも見られますが、これはイオン化した金属の移動のし易さの度合いによるものと考えられ、同じ試験サンプルにおいても上記発生要素の与え方、または絶縁劣化の進行状態により変化することがあります。
デンドライトは主に表層で発生しますが、内層で進行する析出現象はCAF(Conductive Anodic Filaments)と呼ばれます。これは基板繊維の隙間に沿って析出が発生するもので、多層基板のスルーホール間等で見られ高密度実装が多用される近年では注目されています。

実基板の製造工程の品質との関係
スルーホールのドリル加工では、生産性を求めるあまりドリルの送り速度(チップロード)を早くすると内壁の損傷が進みCAFを引き起こす確率が高くなります。及び加工中の温度上昇にも注意が必要です。
基板パターンのエッチング・メッキ工程後の洗浄条件によっても、イオン残さに影響しますので十分な品質管理が必要です。
イオンマイグレーションの試験方法
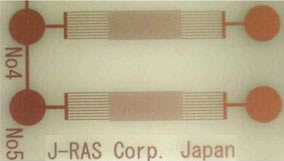
微細くし型パターン:FC
(JPCA-BU01-2007準拠)
イオンマイグレーション試験サンプル
代表的な試験サンプルの形状はくし型パターンで、JPCA規格では標準パターンと微細パターンに分け、その導体幅・導体間隔・重ね代・先端との間隙を規定しています。
くし型パターンを用いず、独自形状の試験サンプルを作成しイオンマイグレーション評価を行う企業も多いのが実情です。
絶縁抵抗計測の方法と測定器
従来、一定時間毎に試験サンプルを環境試験機の槽から取り出し、絶縁抵抗を測定して再び戻す方法がとられてきました。この方法では、ストレスの連続性が無くなる為絶縁劣化傾向にあったサンプルが回復する傾向があります。また、初期のデンドライトは電極間で短絡した瞬間に流れる電流によるジュール熱で焼損する現象(リークタッチ)を繰り返します。
これらのことから、試験サンプルを槽内に入れたまま、連続かつ高速データ収録が可能なイオンマイグレーション試験専用の測定器を信頼性試験に用いることは大変有効です。
イオンマイグレーション試験専用測定器 ECM-100はこちら
環境試験機
恒温恒湿槽
60℃/90%,85℃/85%の環境での試験に用います。フィールドデータとの相関性が高いとされ広く用いられます。欠点として試験時間が500時間〜1000時間以上となるので評価結果を得るまでに長い時間が必要です。
HAST
110℃85%RH以上の高温高湿環境を再現でき、試験サンプルの絶縁劣化現象を短時間で評価することが可能です。しかし、1気圧以上の圧力により試験サンプル内部に強制的に水分を浸透させる効果や、試験温度が素材のガラス転移温度に近い場合もあり、試験条件を決定する場合には注意が必要です。及び、サンプルの絶対評価に使用するのではなく相対評価の使用する方が望ましいと言えます。
イオンマイグレーションの解析方法

ワイブルプロットの例
(当社ECM-100による自動処理)
抵抗値による解析
故障の判定方法
抵抗値が閾値に対して瞬間でも下回ると故障とします。前述したデンドライトのリークタッチ現象は瞬 間的な現象でしかありませんが、フィールドでは重大な事故にもなり得るため故障と して取り扱う必要があります。
ワイブル確率紙による故障パターンの判定
複数の試験サンプルが故障に至るまでの累積時間に着目し、ワイブル確率紙にプロットすることより故障パターンを求めることができます。故障パターンは、初期故障・偶発的故障・摩耗故障に分類され、解析等の情報に役立てられます。顕微鏡による解析
前述の抵抗値による解析手法では、抵抗劣化の物理的な部位が特定できないため顕微鏡による観察が必要になります。内層の場合は試験サンプルのスライスと観察を繰り返して部位を特定します。
参考文献:社)エレクトロニクス実装学会「エレクトロケミカルマイグレーション評価方法 2007年9月」
イオンマイグレーションに関するお問い合わせ
プリント基板や電子材料等に重要な評価項目である絶縁信頼性(イオンマイグレーション)に関連した商品を開発し、それらの販売・受託試験を通して、日本の品質・信頼性に貢献してまいります。
イオンマイグレーション測定器、受託試験についてご質問・ご要望等ございましたら、お気軽にお問い合わせ下さい。

製造業関連情報総合ポータルサイト@engineer
© Cybernavi Inc. All Rights Reserved.



